주사전자현미경의 기본원리와 응용
1. 전자현미경의 기본개념
(1) 전자현미경이란?
최근 정보기기들의 극소화 추세 뿐만 아니라 첨단 소재 분야에서도 극미세 기술의 산업화로 인해미세구조물 또는 재료의 표면형상에 대한 정보가 절실히 요구되고 있다. 특히, 1990년대 후반부터 전세계적으로 나노연구가 활발해지면서 나노물질의 구조와 특성을 규명하기 위한 다양한 연구들이 진행되고 있으며, 전자현미경은 중요한 축을 담당하고 있다.
전자현미경(Electron Microscope)은 광학현미경(Light Microscope)에서 사용하는 가시광선(visible rays) 대신 전자선(electron beam)을, 또한 유리렌즈(glass lens) 대신에 전자렌즈(electron lens)를 사용하여 물체의 확대상을 만드는 장치를 말한다.
1920년대에 기존 현미경의 한계를 극복할 수 있는 새로운 미세 관찰 기술이 요구되었으며, 전자의 자계에 의한 렌즈 작용을 이론화하여 현미경의 새로운 광원으로 전자를 사용하게 되었는데 이를 계기로 새로운 현미경의 이름을 전자현미경이라 부르게 되었다. 전자현미경은 전자에 대한 렌즈작용을 코일에 흐르는 전류를 변환시킴으로써 자계(magnetic field)를 사용하여 전자의 이동 경로를 휘게 하여 마치 볼록렌즈가 빛을 집속하듯 전자를 모아주는 것과 유사하다.
전자현미경은 광선 대신에 전자 빔을 사용하기 때문에 현미경의 내부는 진공상태여야 한다.전자는 공기와 충돌하면 에너지가 소실되거나 굴절되는 등 원하는 대로 제어하기 어렵기 때문이다. 전자현미경은 표본과 대물렌즈와 렌즈 사이의 거리는 일정하지만 중간렌즈와 투영렌즈의 코일에 통하는 전류의 세기에 의해 배율이 결정되며 상의 초점은 대물렌즈의 코일에 흐르는 전류에 의해 조절된다.
광학현미경은 실제의 상을 볼 수 있지만 전자현미경은 형광판이나 사진판을 통해 상을 볼 수 있다. 광학현미경은 표본의 빛을 흡수/반사함으로써 상이 형성되는 반면, 전자현미경에서는 전자선이 시료의 표면에 충돌하면서 발생하는 이차 전자, 산란전자, 투과전자, X-Ray 등을 측정하여 표면의 형태를 영상으로 나타낸다.
(2) 전자현미경으로 얻을 수 있는 정보
전자현미경으로 재료의 표면형상, 적층 결함, 계면 등을 직접 관찰함에 따라 이들이 재료의 여러 성질들에 미치는 영향을 정확히 규명할 수 있다. 전자회절로써 결정의 결자상수와 대칭성 등을 규명할 수 있고, 분석전자현미경으로 원자의 종류와 양을 분석할 수 있다. 그리고 고 분해능 전자현미경으로 원자의 배열을 관찰할 수 있다. 이들 전자현미경 기술을 이용하면 원자의 종류와 위치를 원자 규모로 규명할 수 있고 따라서 이들이 재료의 성질에 미치는 영향을 규명하여 새로운 재료의 개발에 이용할 수 있다.
전자현미경으로 얻을 수 있는 정보는 크게 다음과 같다.
∙ Topography (물체의 표면의 형상을 관찰)
물체의 미세구조와 hardness, reflectivity 등의 물성과 연관성을 규명할 수 있다.
∙ Morphology (물체를 구성하는 입자들의 형상과 크기 관찰)
ductility, strength, reactivity 등의 물성과의 직접적인 관계를 알 수 있다.
∙ Composition (물체를 구성하는 원소와 화합물의 종류 및 상대적인 양을 분석)
분광학에 의한 전자와 시편이 상호 작용하여 생기는 X-선이나 전자를 분석하여 시편 내에 존재하는 원자의 종류와 양을 알아내는 방법으로 에너지 분산 X-선 분광학과 전자 에너지 손실 분광이 있다. 즉, 분광학을 이용한 재료표면의 원소의 종류와 양은 같은 화학적 조성 정보를 제공한다. 녹는점, 반응성, 경도 등 재료물성과 조성과의 관계를 알 수 있다.
∙ Crystallography (재료 내 원자들의 배열상태 분석)
재료의 여러 성질들은 미세 구조, 즉 원자의 종류와 위치에 큰 영향을 받는다. 전자와 시편 내의 원자 간의 간섭을 이용하여 원자의 위치 및 배열에 대한 정보를 얻는 것이다. 회절 패턴을 이용한 결정 구조정보와 같은 역공간의 정보를 제공한다. conductivity, electrical properties, strength 등의 재료고유 물성과 원자배열과의 관계 연구할 수 있다.

(a) (b) (c) (d)
<그림 1> 전자현미경으로 얻을 수 있는 정보. (a) Topography, (b) Morphology, (c) Composition, (d) Crystallography
(3) 전자현미경의 특징
전자현미경은 높은 에너지의 전자빔을 이용하여 전자가 시편과 충돌할 때 발생하는 이차전자,반사전자, X-선 등을 검출하여 확대상을 촬영하는 장치이다.
(주사)전자현미경의 특징을 살펴보면 첫째, 분해능이 높기 때문에 고배율로 물체를 관찰할 수 있다. 열방사형 텅스턴 필라멘트 방식의 SEM은 10만배 이상(분해능: 3~5 nm), 전계방사형SEM(FE-SEM)은 최대 100만배(분해능: 0.5~2 nm)까지 확대상을 얻을 수 있다.
둘째, SEM은 고배율 뿐 아니라 10~100배의 저배율 관찰에도 사용할 수 있다. SEM은 렌즈를 교환하지 않고 단지 코일에 흐르는 전류를 변화시켜 배율을 조절할 수 있기 때문이다. 일반적으로 저배율에서 넓은 면적을 관찰한 후 관심 있는 미세영역을 고배율로 관찰한다.
셋째, 전자현미경은 광학현미경과 달리 피사계 심도가 대단히 깊다. 피사계 심도란 관찰 대상물의 확대영상에서 초점이 맞는 깊이 범위를 말한다. 디지털 카메라와 전문가용 고성능 카메라의 차이를 비교해보면 쉽게 이해할 수 있다. <그림2>은 광학현미경과 전자현미경으로 측정한 영상으로서 SEM 영상은 이차원 데이터임에도 불구하고 마치 3차원 이미지와 유사하여 물체를 훨씬 정확하게 관찰할 수 있다. 따라서 SEM은 요철이 심한 파단면의 관찰이나 표면조도가 큰 시료를 관찰하는데 매우 유리하다.

(a) (b)
<그림 2>동일 생체시료를 관찰한 광학현미경의 이미지(a)와 SEM의 이미지(b)
넷째, 최근 SEM은 디지털 영상을 제공하기 때문에 영상의 저장은 물론 영상에 대한 다양한 분석이 가능하다. 과거에는 소형 CRT 모니터를 통해서 영상을 볼 수 있던 때와 차원이 다른 다양한 기능을 제공한다. 보는 것이 믿는 것이란 말이 있듯이 R&D 분야는 물론 산업체의 품질관리 성적서에서 미세구조물에 대한 영상자료를 제시하는 것 보다 더 확실한 방법은 없을 것이다.
다섯째, 다양한 검출기 및 주변기기를 장착하여 응용분야를 확장할 수 있다. 대표적인 검출기는 후방산란전자를 측정할 수 있는 BSE(back Scattered Electron) 검출기와 특성 X선을 검출할 수 있는 EDS(energy dispersive X-ray spectroscope)와 WDS(wavelength dispersive X-ray spectroscope) 검출기가 대표적이다. 특히, X선 분광분석법은 짧은 시간에 미세영역의 구성성분을 분석할 수 있기 때문에 이차전자 검출기와 함께 필수적 검출기법이 되고 있는 추세이다.
전자현미경의 단점이라면 우선, 고전압(0.5~30 kV)을 사용하여 가속전자를 발생시키므로 여러 가지 복잡한 장치가 요구되며, 전자빔을 이용하기 때문에 진공(10-5 torr 이하)이 필수적이다.이 두 가지 요소(고전압과 진공기술)로 인해 전자현미경은 크고 복잡하며 가격 또한 비쌀 수 밖에 없다.
한편, 전자현미경에서 부도체 시료의 관찰시 전자빔의 전자가 시료에 축적되어 궁극적으로 전자빔을 밀어내는 역할을 하게 되므로 이미지가 왜곡 될 수 있다. 이 때문에 부도체 시료의 경우 표면을 Au 또는 Pt 등의 전도체로 코팅하는 것이 바람직하다.
이와 같은 단점은 생체시료를 측정할 때 많은 한계로 나타나게 된다. 그러나 최근에는 저진공SEM(가변 진공 SEM 또는 Environmental SEM이라고도 함), Cryo-SEM 및 Charge Redution기술 등이 개발되어 SEM의 활용분야가 확장되고 있는 추세이다.
<표1> 전자현미경과 광학현미경의 비교 [1]
주사전자현미경 | 광학현미경 | |
광원 | 전자빔 (파장: 0.6 nm) | 자외-가시광선(파장:200~750 nm) |
매질 | 진공 (10-5 Torr 이하) | 대기 중 |
렌즈 | 전자렌즈 (전기장 이용, Probe 조절) | 광학렌즈 (상 확대) |
분해능 | 일반 SEM: 3~5 nm | 가시영역: 200 nm 자외영역: 100 nm |
초점심도 | 30 | 약 0.1 |
배율 | 10 ~ 30만배 (회로에 흐르는 전류를변화시켜 연속 가변) | 10 ~ 1,000배 (렌즈 교환) |
상 종류 | 이차전자, 반사전자, X-Ray 등 | 투과상, 반사상 |
Contrast | 기하학적 성질, 물리학적 성질 | 광의 흡수 및 반사 (색, 명암) |
주 용도 | Sub-micron inspection | Micro scale inspection |
대부분의 측정기술과 마찬가지로 전자현미경은 탁월한 기법임에 틀림없지만 고유한 영역이 존재하므로 자신의 측정 목적과 용도에 적합한 기술을 사용하는 것이 바람직하다. <그림3>는 측정기법에 따른 영역을 보여주고 있다.

<그림 3> 각 측정기법의 적용 영역
(4) 전자빔과 시료의 상호작용
전자빔이 시료 표면에 입사되면 표면에서 이차전자가 주로 튀어나오며, 대부분의 SEM은 이차전자 검출기를 표준으로 사용하고 있다. 그 외에도 전자빔은 시료와 충돌하여 후방산란전자 등 다양한 현상이 발생하고, 이를 활용하여 다양한 형태의 측정이 가능하다(그림4).
전자빔이 입사되면서 시료와 상호작용은 표면에서의 깊이에 따라 주요 기작이 다르게 나타나는데 <그림5>는 20kV 전자빔이 니켈 시편의 표면에 직각으로 입사될 때, 상호작용하는 부피를 나타낸 것이다.
이러한 상호작용 및 그 결과가 탐지되고 이미지로서 모니터, CRT, 혹은 필름에 기록된다. 위의 단계들은 전자현미경의 종류에 관계없이 모두 발생하게 되며, 세부적인 구조 및 기능 사항은 제조업체에 따라 약간의 차이가 있다.
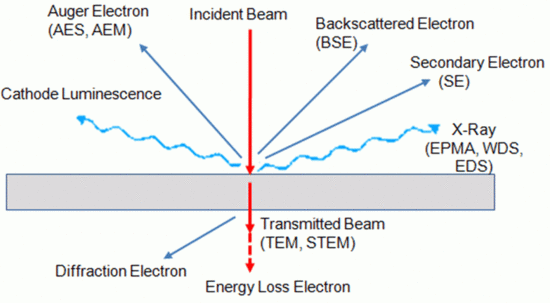
<그림 4> 시편에 전자가 입사할 경우 발생하는 여러 종류의 신호

<그림5> 니켈 시편에 입사된 전자빔의 상호작용
(5) 전자현미경의 종류
SEM (Scanning Electron Microscopy, 주사전자현미경)
10-5 Torr 이상의 진공 중에 놓여진 시료표면을 1~100 nm 정도의 미세한 전자선으로 x-y의 이차원방향으로 주사하여 시료표면에서 발생하는 이차전자, 반사전자, 투과전자, 가시광, 적외선, X선, 내부 기전력 등의 신호를 검출하여 모니터에 확대상을 표시하며, 시료의 형태, 미세구조의 관찰이나 구성원소의 분포, 정성, 정량 등의 분석하는 장치이다. 주로 금속 등 도체, IC,산화물 등 반도체, 고분자 재료나 세라믹 등 절연물의 고체, 분말, 박막시료가 표본이 된다.
자기렌즈를 이용하여 전자빔을 가늘게 집속하며, 이를 시료면 위를 주사함으로써 발생하는 이차전자를 검출한다. 이차전자의 양은 표면의 물질과 표면의 굴곡에 따르기 때문에 표면의 미세한 확대상을 얻을 수 있다. 배율은 시료면 위와 형광면(모니터) 위의 주사 진폭의 비로 정해진다. SEM의 분해능은 전자빔을 가늘게 만들수록 높아지는데 보통은 3~5 ㎚ 정도로 쓰인다.
TEM (Transmission Electron Microscopy, 투과전자현미경)
TEM은 필라멘트에서 나온 전자를 가속하여 양극의 구멍을 빠져 나온 전자빔을 얇게 자른 시편에 통과시켜 상을 얻고. 그 상을 전자렌즈로 차례차례 확대하여(대물·중간·투영의 3단 렌즈)마지막 단계의 상을 형광판에서 관찰하고 카메라로 찍는다. 전자빔의 통로는 물론 모두 진공으로 되어 있다. 직류전류를 조절하면 렌즈의 세기(초점거리)가 달라진다.
시료는 앞뒤 좌우로 옮겨 바라는 지점을 찾아 배율을 적절히 택하여 관찰하고 촬영한다. 높은 배율의 경우에는 고도의 숙련도가 요구된다. 시료의 두께가 100㎚를 넘으면 전자빔이 거의 투과하지 못하여 윤곽밖에 보이지 않으므로 내부 구조를 보려면 더 얇게 만들어야 한다.
금속 덩어리를 얇은 조각의 시료로 자르는 데에는 전해연마법이 쓰인다. 이렇게 얻은 시료에서는 여러 가지 격자상의 결함이 관찰된다. 생물의 조직의 경우 고정시켜서 유리나 다이아몬드칼로 아주 얇은 조각으로 자른다. TEM으로 직접 표면을 볼 수는 없으나 표면의 굴곡을 얇은 막에 찍어서 볼 수 있다.
(6) 전자현미경의 작동 원리
앞에서 언급한 것처럼 전자현미경은 가시광선 대신 전자빔을 사용하기 때문에 현미경의 내부는 진공상태이고, 배율은 중간렌즈와 투영렌즈의 코일에 통하는 전류의 세기에 의해 결정되며 상의 초점은 대물렌즈의 코일에 흐르는 전류에 의해 조절된다. 광학현미경은 실제의 상을 볼 수 있지만 전자현미경은 형광판이나 사진판(아날로그 SEM), 모니터(디지털 SEM) 등을 통해 영상을 볼 수 있다. 광학현미경은 표본의 빛을 흡수함으로써 상이 형성되는 반면, 전자현미경에서는 전자가 표본의 원자에 의해 산란됨으로써 상이 형성된다. 무거운 원자는 산란도가 크므로 가벼운 원자에 비해 짙은 상을 만든다.
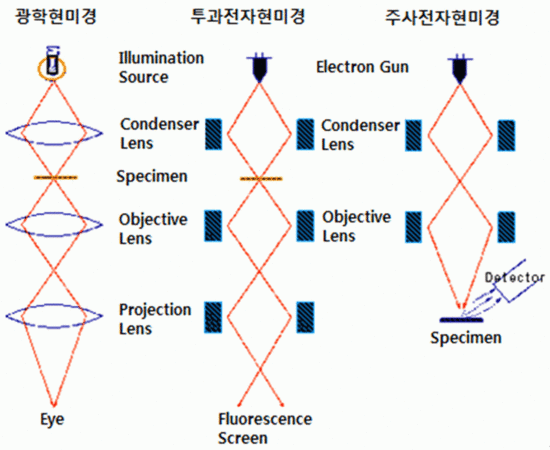
<그림 6> 광학현미경과 전자현미경의 모식도
전자현미경, 특히 투과전자현미경은 <그림6>에서 보는 바와 같이 가시광선 대신에 집속된 전자빔을 사용한다는 것 외에는 광학현미경과 작동원리는 유사하다. 대부분의 전자현미경의 동작원리는 다음과 같다.
· 전자총에 전압을 인가하면 필라멘트에서 전자가 방출되며, 일련의 전자다발은 양극(anode)에 인가된 전기장에 의하여 시료를 향하여 가속된다.
· 전자다발 중에서 aperture의 홀을 통과한 것들은 자기장을 이용한 자기렌즈에 의해서 집속되고 파장이 일정한(monochromatic) 전자빔을 형성한다.
· 이 전자빔이 다시 자기장을 이용한 대물렌즈에 의해서 시편에 초점을 형성한다. 이 때 수차가 발생할 경우 stigmator에 의해 조정할 수 있다.
· 시편에 입사되는 전자들과 시편 내에 포함된 원자 및 전자들이 상호작용하여 이차전자,후방산란전자 등이 방출되며, 적절한 검출기를 통해 이들을 포집하여 디지털 신호로 변환시킨다.
· 디지털 신호로 획득된 신호는 컴퓨터에서 적절한 알고리즘에 의해 재해석한 후 영상으로 모니터에 출력 또는 저장된다.
(7) 전자현미경의 분해능
광학현미경과 전자현미경은 근본적인 구조는 유사하다. 다만, 광학현미경은 관찰의 매체로 가시광선을 사용하고, 전자현미경은 전자빔을 사용한다는 점과 광학현미경은 유리 렌즈로 빛을 집속하는데 비해 전자현미경은 전자기 렌즈를 이용하여 전자빔을 집속한다는 차이가 있다.
렌즈를 통과한 빛은 <그림7>와 같이 회절현상에 의해 간섭무늬를 형성하며, 이를 에어리 원반이라고 부른다. 만약 시편 상에 일정한 거리에 있는 두 점에서 출발한 빛이 렌즈를 통과할 경우 스크린 상에 두 개의 원반이 만들어지게 되며, 이 두 점의 거리가 가까워지면 두 원반이 서로 근접하여 겹쳐 보이게 된다. <그림8>에서와 같이 두 원반이 어느 거리 이상 근접하면 관찰자는 더 이상 두 점을 분해하지 못하고 하나의 점으로 인식하게 된다. 이 한계점에서 시편 상의 두 점 사이의 거리를 분해능(resolution)이라 부른다. [1]

(a) (b)
<그림 7> 렌즈에서의 빛의 회절현상(a)과 간섭무늬인 에어리 원반(b) [1]
 (a) (b) (c)
(a) (b) (c)
<그림 8> 시편 상의 두 점 사이의 간격 r이 분해능 한계 d보다 클 때(a), 같을 때(b), 작을 때(c)의 간섭현상. (c)에서는 확대영상에서 두 점은 더 이상 구분할 수 없으므로 하나의 점으로 인식하게 된다. [1]
광학 현미경의 분해능(d)은 Abbe의 법칙에 의해 (식 1)과 같이 파장(λ)에 비례한다. 여기서n은 매질의 굴절율, α는 개구각이다. 파장이 짧을수록 분해능의 크기가 작아지며, 분해능이 좋아진다. 광학현미경의 경우 가장 짧은 가시광선(약 200 nm)을 사용하더라도 그 분해능은 0.1㎛보다 좋아질 수가 없다.
(식 1) (식 2)
(식 2)
전자현미경에 사용되는 전자빔의 파장은 전자가 갖은 에너지 함수이고, 전자의 에너지는 전자총에서 전자를 가속할 때 가해주는 가속전압의 함수이다. 전자빔의 파장은 (식2)와 같이 가속전압 V의 0.5제곱에 반비례한다. 만약 가속전압이 100 kV라면 이론적 분해능은 2.3Å이 된다.즉, 전자현미경의 분해능은 광학현미경의 분해능 0.1 ㎛ 보다 약 400배 정도 뛰어나다고 할 수 있다.
2. 전자현미경의 발전과정
(1) 전자현미경의 발명
19세기 말에 광학현미경의 개량에 공헌을 한 독일의 물리학자 압베(E. Abbe)는 광학현미경의 분해능은 가시광선을 사용하는 한 그 파장이 짧은 자외선 쪽에 가까운 파장의 빛을 이용하더라도 분해능은 0.2㎛에 지나지 않으며, 물체를 확대해 볼 수 있는 배율은 이론적으로 3,000배 이상은 선명하게 관찰하기 어렵다는 것을 밝혔다. 그러나 이는 이론적인 배율이며 대부분의 현미경은 1,000배 이상 관찰할 수 없다.
20세기 초 의학 및 생물학 분야의 연구자들은 광학현미경으로 보이지 않는 바이러스의 정체를 규명하기 위한 다양한 시도를 했으며, 이 때문에 배율이 높고 분해능이 뛰어난 현미경의 개발이 절실히 요구되었다.
1926년 Hans Busch는 전자의 자계에 의한 렌즈 작용을 이론화하여 현미경의 새로운 광원으로 전자를 사용하게 하는 계기를 마련했으며, 이 때문에 새로운 현미경의 이름이 전자현미경이라 불리게 되었다. 전자에 대한 렌즈작용은 코일에 흐르는 전류를 변환시킴으로써 자계(magnetic field)를 사용하여 전자의 이동 경로를 휘게 하여 마치 볼록렌즈가 빛을 집속하듯 전자를 모아주는 현상과 관련이 있다.
1931년 독일 베를린기술대학교 크놀(Max Knoll) 과 그의 학생이었던 루스카(E. Ruska)는 전자빔을 사용하여 투과전자현미경(TEM)을 제작하였으며, Ruska 박사는 이후에도 전자현미경의 발전에 지대한 공헌을 하였다. Ruska 박사는 1986년에 그 공로를 인정받아서 1986년에 노벨물리학상을 수상하였다.

<그림 9> 1938년 Siemens에 의해 시판된 최초의 상용 전자현미경 [17]
1938년 Siemens(독일)는 최초의 전자현미경(TEM)을 상용화했으며, 40년 RCA(미국), 41년Hitachi(일본), 49년 Philips(네덜란드)가 상용 제품을 판매하면서 전자현미경이 널리 보급되었다. [2]
주사전자현미경(SEM)은 Knoll이 1935년에 전자선속 스캐너(electron beam scanner)가 그 효시라 할 수 있으며, 최초의 상용제품은 Cambridge Instrument에 의해 62년 개발되었다. 72년에는 Hitachi가 100만배까지 측정할 수 있는 고분해능 FE-SEM을 개발하여 SEM의 활용 가능한 영역을 넓혔으며, 90년에는 chamber의 진공도를 낮게 유지하면서 시료의 charge-up 현상을 방지함으로써 시료에 coating을 하지 않고도 관찰이 가능한 저진공 SEM이 JEOL에 의해 개발되었다. 현재 미세 영역의 성분분석을 위해 널리 사용되고 있는 EDS의 경우 68년에 개발되었다. [3]

<그림 10> 1970년 C.N.R.S Lab에 만들어진 3 MV HVEM
고압전자현미경(HVEM)은 1965년에 가속전압이 500 kV인 고압전자현미경이 Hitachi에서 처음으로 개발되었으며, 2000년에는 역사적인 1 MV FE-TEM의 개발로 분해능이 0.0498 nm까지 실현되었다. 앞으로 미래에는 더욱 우수한 전자현미경이 개발되어 사람의 눈으로 직접 원자 단위의 구조도 관찰이 가능하리라 여겨진다.
예를 들어, 기초과학지원연구원 대전본원에 설치된 HVEM의 경우 세계 최고의 성능을 자랑하고 있으며 원자분해능(0.12㎚)을 가지며 고경사각(±60°)의 실행이 가능하여 무기물질 및 생체물질의 삼차원 구조를 원자 수준으로 분석하는데 유용하다. 또한 본체에 부착된 최신 에너지 여과장치(HV-GIF)와 다양한 변온 시료지지대(액체 헬륨 온도~1500℃)를 사용할 수 있고 필요 시 원자로와 핵융합로 재료 등 극한 물질의 개발에 필요한 이온빔 가속장치를 본체에 부착하여 사용할 수 있다.
(2) 국내 전자현미경 개발 역사
국내 최초의 전자현미경은 1958년으로서 Hitach가 경북대 안영필 교수에게 기증한 HM-3 모델이며(현재 한국기초과학지원연구원 전시되어 있다), 70년대에 이르러서 널리 사용하게 되었다. 현재까지 대략 2,000대 이상 보급되어 그 중 절반 정도가 구동되는 것으로 추정하고 있다.
77년부터 일본 Akashi가 출자한 전자현미경 생산업체인 한국ISI 공장이 마산수출자유지역에 건립되어 Akashi의 기술로 개발한 SEM을 매년 350대 이상 제작하여 수출한 바 있다. 그러나 안타깝게도 당시 국내에 전자현미경 관련 기반 기술과 설계기술 부재, 부품산업의 취약성, 연구인력의 부재로 인해 Akashi가 국내 관련 산업의 발전에 거의 기여하지 못했다. 93년 이 회사는 도시바 계열사인 Topcon에 합병되면서 90년대 후반에 마산공장을 폐쇄하게 된다.
국내의 전자빔 및 이온빔 관련 연구의 대부분은 미국을 중심으로 수학하고 귀국한 연구자들에 의해 수행되고 있으나 주로 고전압 가속기 분야나 응용분야를 연구하고 있기 때문에 자기렌즈를 이용한 화상처리까지 가능한 전자현미경의 원천기술 연구는 취약한 실정이었다.
본격적인 전자현미경 국산화는 2000년대 초반부터 표준과학연구원 조양구 박사팀과 서울산업대 장영동 교수팀에 의해 수행되고 있다. 표준과학연구원의 연구성과는 2007년도에 ㈜코셈에 기술 이전되어 2008년부터 CX-100S 모델이 판매되고 있으며, 현재는 FE-SEM과 TEM 기술을 개발하고 있다. 서울산업대의 경우 mini-SEM 시제품 생산한 후 상품화를 준비하고 있으며, 지금은 FE-SEM을 개발에 주력하고 있다.
한편, 기존의 SEM/TEM과는 다른 연구형태를 살펴보면 선문대 김호섭 교수의 경우 마이크로 컬럼을 개발하여 이를 array 형태로 배열하여 반도체 process용 전자현미경에 적용하거나micro-lithography에 적용하기 위한 연구를 수행하고 있으며, 표준연 첨단측정기술센터의 박병천 박사팀은 SEM과 AFM을 융합시켜 또다른 적용분야를 개척하고 있다.
산업계의 경우 2000년대 초에 벤처기업인 미래로시스템이 국내에서 생산하였으나 기술적 한계로 인하여 전자현미경의 핵심기술인 컬럼부를 러시아에서 수입하고 있다. 최근에는 ㈜코셈 외에도 일부 벤처기업들이 산학연 협력을 통해 전자현미경을 공급하고 있지만 아직까지 mini-SEM과 보급형인 텅스턴 필라멘트 SEM 수준이고, FE-SEM, TEM, CD-SEM과 같은 고가의 정밀 장비는 대부분 수입에 의존하고 있다.
나노산업 및 관련 융합기술 분야의 Platform 기술인 전자현미경의 중요성으로 볼 때 대단히 안타까운 현실로서 나노기술의 국제경쟁력 강화를 위해서는 개별 벤처기업 차원이 아닌 정부 차원의 과감한 투자가 요구된다. 2차대전이 끝난 후 일본이 과학기술 진흥을 위해 전자현미경 분야에 집중적인 투자를 하여 60대 이후 세계시장을 주도했던 사례를 주의 깊게 살펴볼 필요가 있다.
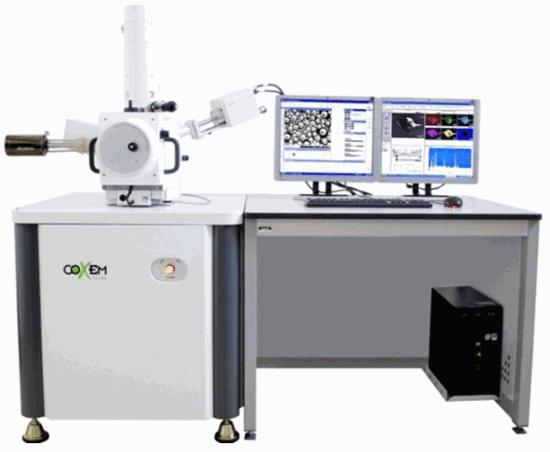
<그림 11> 표준연의 기술이전으로 국산화된 ㈜코셈의 CX-100S SEM
3. 주사전자현미경의 구성
주사전자현미경(Scanning Electron Microscope)은 고체 상태에서 작은 크기의 미세 조직과 형상을 관찰할 때 널리 쓰이는 현미경으로서 1965년 최초로 상품화된 후 초점 심도가 깊고 3차원적인 영상의 관찰이 용이해서 복잡한 표면구조나 결정 외형 등의 입체적인 형상을 높은 배율로 관찰할 수 있는 분석 장비이다. 활용도도 매우 다양해서 금속 파편, 광물과 화석, 반도체 소자와 회로망의 품질 검사, 고분자 및 유기물, 생체 시료와 유가공 제품 등 전 산업 영역에 걸쳐 있다. 특히 X-선을 이용하여 작은 부피의 화학 조성을 빠르고 정확하게 측정할 수 있어서SEM의 활용분야를 획기적으로 확장해주고 있다.
SEM은 집속렌즈(condenser lens)와 대물렌즈(objective lens)를 가지고 있으나, 광학현미경이나 투과전자현미경(TEM)처럼 빛의 법칙에 따라서 화면을 형성하지 않고, 전자기렌즈가 전기가 통하는 시편의 표면에 초점을 형성한 전자빔 spot을 형성하고 이 spot이 관찰하고자 하는 시편부위를 주사하여 영상을 형성한다. 이 과정 중에 여러 형태의 radiation이 발생하지만SEM에서는 시편의 가장 표면에 가까운 영역에서 발생하는 이차전자(secondary electron)를 이용해 영상을 출력한다. SEM 이미지에서 한 점의 밝기(brightness)는 전자빔과 시편의 상호작용에 의해서 시편의 해당 부위에서 발생되는 이차전자의 수에 비례한다. 전자빔이 시편의 각 점에서 이차전자의 신호를 수집하여 정해진 크기의 pixel로 기록한다.
SEM은 <그림12>에서 보는 바와 같이 컬럼부는 전자빔을 발생 및 가속시키는 전자총(electron gun), 전자빔을 가늘게 모아주는 집속렌즈와 대물렌즈, 필라멘트를 떠난 전자가 시편에 닿을 때까지 전자빔의 경로를 조절하는 주사코일(deflection coil)로 구성되어 있다. 컬럼 아래쪽의 진공 경통 안에는 시편을 이동시키는 시료 stage가 위치하고, 경통에는 이차전자 검출기 등 다양한 검출기를 부착할 수 있다. 장비의 하단부는 진공 챔버를 10-5 torr 이하로 유지해주는 진공펌프, 전자총과 검출기 등에 고전압을 공급하는 고전압 공급장치, 전체 시스템을 제어하거나 수집된 신호를 처리하는 Electronics, 외부에서 장비에 전달되는 진동을 차단하는 제진대 등으로 구성된다. 10년 전만 하더라도 SEM은 덩치가 큰 부품들이 복잡하게 붙어 있었으나 최근에는 전자부품의 소형화 및 고성능, 고기능화로 인해 단순화되면서도 신호처리 속도는 현저하게 향상되었다.
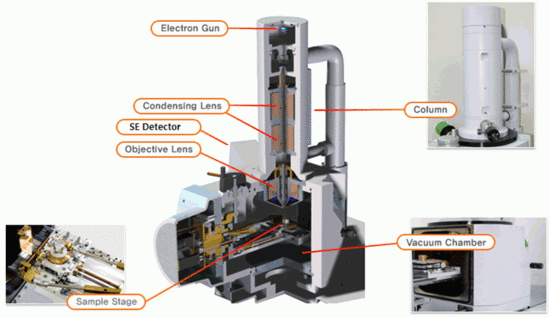
<그림12> 주사전자현미경 Column의 3차원 모형도. ㈜코셈의 CX-100S 모델 기준.
(1) 전자총(electron gun)
전자총의 역할은 전자를 만들고 가속시키는 역할을 한다. 전자총은 전자선(electron ray)의 형태로 사용되는 안정된 전자원을 공급한다. 충분한 양의 이차전자를 생산할 수 있을 만큼 많은 양의 1차 전자를 만들되, 자기렌즈에 의해서 작은 빔을 효과적으로 형성하도록 고안되어 있다.원자 내의 전자는 원자핵과의 전기력 작용에 의하여 특정 위치에서 일정한 에너지를 갖고 있기 때문에 전자가 상온에서 자기 위치를 벗어나 공중으로 방출되는 일은 거의 일어나지 않지만 전자가 갖고 있는 에너지 장벽(일함수; work function) 이상의 에너지가 주어질 경우 전자가 튕겨져 나오게 된다. 즉, 전자총의 필라멘트로 사용되는 텅스텐과 같은 금속을 높은 온도로 가열시키면, 표면의 원자에 구속되어 있던 전자들이 원자핵의 속박에서 벗어나 진공 중으로 이탈된다.
SEM의 전자총에는 열방사형(thermionic electron gun)과 전계방사형(field emission electron gun)으로 나뉘어진다.
열방사형(thermal emission)의 경우 음극은 주로 텅스텐으로 약 100㎛ 직경의 선 필라멘트로서 끝이 V자 모양을 가진 머리핀 모양으로 구부러져 있다(그림 10, 11). 텅스텐은 일함수 값이4.5 eV로 크지 않고, 융점은 3,650K로 매우 높기 때문에 필라멘트로 많이 사용되며, 일반적으로 필라멘트에 직접 전류를 가하여 약 2,700K까지 가열한다. 한편, 고급 전자현미경에서는 발생된 전자의 밀도(즉, 단위각도상 단위면적당 전자의 수)를 높이기 위해서 LaB6(lanthanium hexaboride)를 사용하며, 1900K의 온도로 가열하여 사용한다. LaB6는 표면 원자흡착에 의해 전자방출성이 현저히 떨어지는 문제가 있으므로 고진공을 유지하여야 한다.
필라멘트에서 튕겨져 나온 전자는 1~30 kV의 고압을 걸어서 가속시킨다. 전자총은 <그림10>과 같이 윗부분에 필라멘트 전원(cathode)과 필라멘트가 있고, 필라멘트 주위를 감싸고 있는 wehnelt cylinder, 아래쪽에 가속전극 역할을 하는 양극판(anode plate) 등으로 구성되어 있다. 30kV의 고전압을 발생시키는 고압회로의 전압 및 전류의 안정도는 SEM 이미지의 화질에 지대한 영향을 미치므로 치밀한 설계가 요구된다.
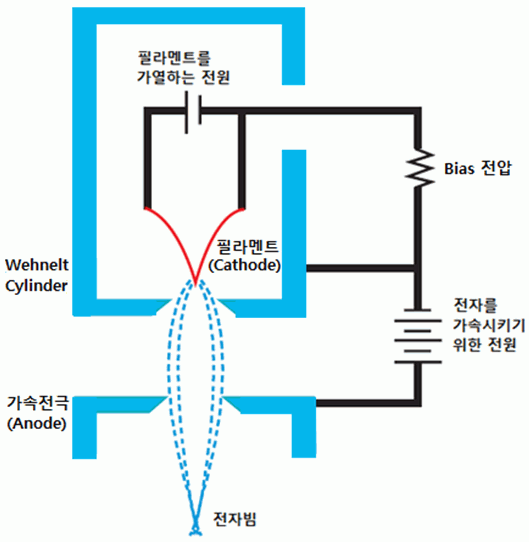
<그림13> Hair Pin 형태의 열방사형 전자총의 모식도 [9]
wehnelt cylinder에 바이어스 전압이 가해지면 wehnelt cylinder는 음극인 필라멘트보다 더 마이너스 전압을 띠게 되고, 이로 인해 필라멘트에서 방출된 전자는 척력을 받게 되어 가운데로 집속된다. 음극인 필라멘트와 양극판 사이에 가해지는 전압을 가속전압이라고 하는데 이에 의해 필라멘트에서 방출된 전자가 가속되어 아래 방향으로 방사되면서 전자빔을 형성하게 된다.

<그림 14> 전자총 외부, Wehnelt 실린더, 텅스턴 필라멘트 사진
전계방사형(field emission) 전자총은 <그림15>와 같이 팁(cathode), 1차 양극, 2차 양극으로 구성된다. 팁은 W-point tip을 600~2000 Å의 곡률반경을 가지도록 뾰족하게 제작한 후 강한 전기장을 가하여 potential 장벽의 두께를 줄여줌에 따라 전자가 텅스텐 표면 밖으로 투과되어 나가는 원리를 이용하고 있다. FE 전자총은 점원으로부터 균일한 에너지의 전자선이 얻어지므로 대단히 높은 전자선 밝기와 작은 교차점을 형성할 수 있어서 고해상도를 얻을 수 있다. 1차 양극은 3~5 kV의 고전압을 가하여 팁으로부터 전자를 방출하게 하고 2차 양극은 전자를 가속시키는 역할을 하는데 2차 양극과 팁 사이에는 최대 30kV의 가속전압이 가해지게 된다.전계방사형의 경우 열을 전혀 가하지 않는 상온형(CFE; cold cathode field emitter), 고온형(TFE; thermally assisted field emitter), 쇼트키형(SE; Schottky field emitter)가 있다.
3세대 전자총이라 할 수 있는 Schottky 방식은 텅스텐 팁의 열전자방식 보다 낮은 온도로 가열하여 텅스텐의 일함수를 낮추고, 다른 방식 보다 작은 전기장으로 텅스텐 표면으로부터 전자를 방출하는 원리로서 차세대 전자총으로 발전할 것으로 보인다.

<그림 15> 전계방사형 전자총의 모식도와 Schottky field emitter assembly
<표2> 전자총의 비교 [1]
방사원 | 휘도 | 수명 | 방사원 크기 | 에너지 분산(eV) | 전류안정도(%) | 진공도 |
텅스텐 | 105 | 40 ~ 100 | 30~100 ㎛ | 1 | 1 | 10-3 |
LaB6 | 106 | 200 ~1000 | 5~50 ㎛ | 1 | 1 | 10-5 |
전계방사형 상온형 고온형 Shottky형 | 108 108 108 | > 1000 > 1000 > 1000 | < 5 nm < 5 nm 15~30 nm | 0.3 1 0.3~1 | 5 5 2 | 10-7 10-6 |
(2) 전자기 렌즈 (Electromagnetic Lens)
전자기렌즈는 코일이 감아진 원통형의 전자석으로 전자가 자장에 의해 휘는 성질을 이용하여 전자를 한 곳으로 모으는 역할을 한다(그림16). 광축에 원대칭을 이루는 자장에 의해 광축을 따라서 진행하는 가속된 전자가 나사형 괘적을 이루면서 초점을 형성한다. 광학현미경에서는 렌즈가 대상물의 크기를 확대하지만 전자현미경에서는 렌즈에 의해 전자빔의 크기가 축소되며, 이를 반확대(demagnification)라고 한다.
자기 렌즈는 항상 볼록렌즈의 역할을 하는데 렌즈의 초점거리는 다음과 같다.
(식 3) 
이 식에서 e와 m은 전자의 전하량과 질량이고 V는 가속전압이다. Bz는 자장의 세기로 코일에 걸어주는 전류에 따라 연속적으로 변화시킬 수 있으므로 유리렌즈에서 초점거리가 유리의 곡면반경에 의해서 정해지는 것에 비하면 커다란 장점이다.
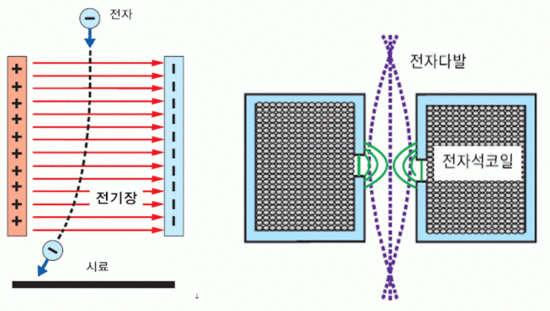
<그림 16> 전기장에서의 전자의 굴절과 전자기 렌즈 모식도
n 렌즈 (Condensing & Objective Lens)
전자총에서 나오는 전자빔의 크기는 약 10∼50㎛로서 보통 2개의 집속렌즈와 1개의 대물렌즈를 이용하고, 시편에 주사되는 전자빔의 크기의 약 1/10000인 5∼200nm정도이다. 전자빔이 가늘수록 표면의 모양을 더 자세히 관찰할 수 있다.
필라멘트에서 나오는 전자는 여러 방향으로 퍼져서 나오기 때문에 전자빔을 가늘게 만들려면 바깥쪽에 있는 전자를 안쪽으로 밀어 넣어야 된다. 전자현미경에서는 <그림17>와 같이 전자석(집속렌즈)을 이용하여 전자빔을 가늘게 만든다.
집속렌즈는 전자총을 빠져나온 전자빔을 모아주는 역할을 하며 조리개(aperture, 50~200㎛)와 함께 조합하여 전자빔의 세기를 결정하는 요소가 된다. 조리개의 크기가 작으면 spot size가 작아지고 통과하는 전자들의 수가 감소하며 구면수차(spherical aberration)를 감소시킨다.
시료에 조사되는 빔의 크기를 결정하는 대물렌즈는 전자빔 형성렌즈로도 불리는데, 작은 전자빔을 만들기 위해서는 초점거리가 짧고 시료의 표면에 가깝게 위치되도록 한다. 2개의 주사코일과 한 쌍의 stigmator로 구성되어 있다. 주사코일은 scan generator에 연결되어 시료 표면에 형성된 전자빔의 spot을 체계적으로 이동시킬 수 있도록 되어있다. Stigmator는 시편에 입사되는 전자빔이나 시편에서 방출되는 이차전자의 spot이 정확히 둥굴지 않을 경우 spot의 일그러진 방향에 반대의 전자기장을 걸어서 교정하는 기능을 한다.
대물렌즈와 시료표면 사이의 거리를 작동거리(working distance)라 하는데, 작동거리가 짧을수록 더욱 작은 점을 형성할 수 있으며, 영상의 해상도가 좋아진다. 대물렌즈 속에는 주사코일,조리개와 비점수차코일 등이 들어있으며, 대물렌즈로 전자빔을 시료의 표면에 초점을 맞추므로 영상의 배율이 변하여도 초점은 변하지 않는다.
렌즈를 설계할 때 제약요소는 렌즈와 시편 사이의 공간을 전자검출기와 공유해야 하며, 다소 여유 있는 working distance를 갖고 있는 것이 좋다. 시료를 절단하지 않고 가급적 큰 시료를 바로 측정해야 할 때가 많기 때문이다. 과거에는 <그림18>의 평면 pin hole 렌즈를 많이 사용하였으나 최근에는 반도체 웨이퍼의 대형화 등으로 60도 conical 렌즈를 주로 채용하고 있다.
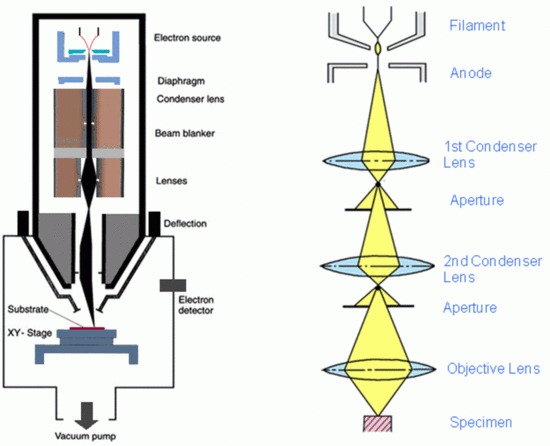
<그림17>렌즈를 포함한 SEM 컬럼 모식도와 Beam focusing 과정
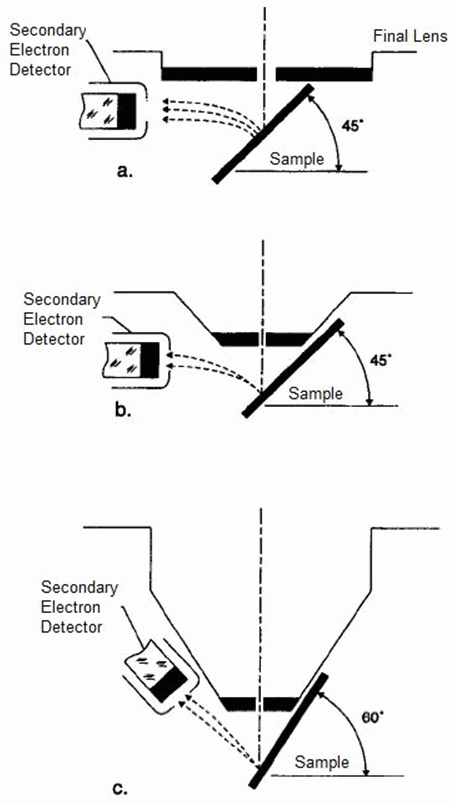
<그림 18> pin hole lens의 다양한 형태 (a) 평면렌즈 (b) 45도 conical 렌즈 (3) 60도 conical렌즈 [2]
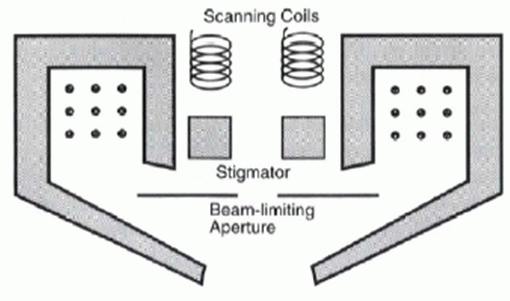
<그림 19> 대물렌즈의 Cross Section
n 조리개 (Aperature)
<그림15>처럼 anode에서 가속된 전자들은 2~3개의 집속렌즈를 거치면서 2 nm 이하 크기의beam spot을 형성한다. 일반적으로 spot의 크기가 작을수록 SEM의 분해능이 증가한다. 각각의 렌즈는 고정 또는 가변 조리개(aperature)를 가지고 있어서 spot size를 줄이거나 구면수차(spherical aberration)를 감소시키는데 이용된다.
조리개는 지름이 50 ~ 600 ㎛ 크기를 갖고 있으며 크기가 작으면 spot size가 작아지고 통과하는 전자들의 수가 감소하며 구면수차(spherical aberration)를 감소시켜 depth of field를 증가시킨다. Depth of field는 또한 마지막 대물렌즈의 아래쪽부터 시편까지의 거리(working distancd)에 의해서 영향받는다. WD가 증가하면 aperture angle이 감소하므로 WD를 증가시키면 depth of field도 따라서 증가한다.

(a) 100 ㎛ (b) 200 ㎛ (c) 600 ㎛
<그림 20> 대물렌즈 조리개의 조정에 따른 이미지 변화 [11]
n 축조정 코일
전자총의 중심축과 집속렌즈의 중심축이 기계적으로 위치가 흩어져 있으면 전자총에서 방사되어 집속렌즈에 들어가는 전자선이 어긋나게 된다. 이는 렌즈의 수차발생의 원인이 되며 분해능을 떨어뜨리게 된다. 이때 전자총의 음극 바로 밑에서 전극 코일을 통해 X-Y축 방향으로 적당량을 편향하여 집속렌즈의 축에 일치시킨다.
n 주사 코일
주사 코일은 집속렌즈와 대물렌즈 사이에 위치하여 전자빔을 대물렌즈 중심의 한 점에 편향시키는 역할을 한다.
n 비점수차 보정 코일(Stigmator)
컬럼의 오염이나 전자기장 또는 광학계의 미세한 결함에 의해 spot의 형태가 왜곡될 수 있으며, 그 결과 초점이 맞지 않게 되어 해상도를 떨어뜨리게 된다. 이를 보정하는 코일을 비점수차 보정 코일(stigmater)이라 하며, 전류를 적절하게 조절하여 보완하는 방법이다. Stigmator는 렌즈 내에 부착된 octupole이라 불리는 8개의 분할된 전자석으로 구성되며, 전자석에 선별적으로 자기장을 부가하여 렌즈의 원래 자기장 크기의 비대칭성을 교정한다.

<그림 21> 8개의 자석에 의해 비점수차를 조절하는 Stimator의 작동 예 [11]
n 프로브의 형성
전자렌즈의 작용에 의하여 미세한 전자빔 형태로 만들어지는 프로브는 시편 표면을 주사하면서 신호를 발생시켜 실제 영상을 형성토록 한다. 영상에서 화소(pixel)가 기본 단위인 것처럼 영상에 대응하는 시편 상 주사면에서는 프로브가 기본단위가 된다. 프로브의 크기에 따라 분해능이 결정되며 프로브 전류량의 크기에 따라 화질이 결정된다. 프로브의 크기와 전류량은 전자총과 전자기 렌즈로 구성되는 전자광학계에 의하여 결정된다.
프로브의 크기를 결정하는 요소로는 회절효과와 렌즈의 수차가 있다. 회절효과는 렌즈를 통과할 때 경로차에 의하여 만들어지는 에어리 원반 때문에 분해능의 저하가 생기는 것을 말하는데 전자기파의 파장에 따라서 원천적 분해능의 한계는 규정되어 있다. 렌즈의 수차는 구면수차, 색수차 및 비점수차가 있으며, 주로 전자광학계의 결함에 의하여 발생하는데 프로브를 확장시켜 분해능의 저하를 초래한다.
n 시료표면 Scanning 및 초점 조절
SEM은 전자빔을 시료의 한 지점에 충돌시켜 그 곳에서 튕겨 나오는 전자의 양을 측정한 후 전자빔의 spot을 바로 옆으로 옮기면서 차례대로 주사해야 관심있는 영역의 전체 표면 영상을 얻을 수 있다. SEM에서는 전기력을 이용하여 spot을 이동시키며 이는 코일에 흐르는 전류를 조절하여 제어한다. 전류를 변화시키면 전기장의 세기가 변하며, 전기장 내에서 전자가 휘는 정도가 달라지기 때문이다.
집속렌즈에 의해 한 점에 모인 전자빔은 시료 쪽으로 내려오면서 다시 원뿔 모양으로 퍼진다.선명한 영상을 얻기 위해서는 전자빔이 가늘수록 좋기 때문에 시료 표면에 부딪치는 지점에 초점을 맞추어야 한다.
(3) 영상신호 검출장치
광학현미경과 달리 전자현미경의 영상은 눈으로 직접 볼 수 없으므로 모니터에 그림으로 나타내게 된다. 즉, <그림22>과 같이 화면의 각 점(pixel)의 명암으로 영상을 나타내며 SEM에서는 각 spot에서 튕겨 나온 전자의 양에 따라 명암이 구분된다.

<그림22> 디지털 SEM의 영상검출의 기본원리 [9]
20∼30keV의 에너지를 갖고 시료에 입사된 전자빔은 시료의 원자와 탄성 또는 비탄성 충돌을 하며, 이차 전자, 후방산란 전자, X선 및 가시광선과 같은 신호를 발생시킨다. 대표적인 것으로는 이차 전자 및 시료표면에서 반사되어 후방으로 산란된 전자이다. 이 두 종류의 전자들은 매우 다른 에너지를 가지므로 두 개의 다른 전자검출기로 측정한다.
n 이차전자 검출기 (SED; secondary electron detector)
이차전자는 에너지가 비교적 낮고 표면형상에 대한 상세한 정보를 제공한다. 뿐만 아니라 검출기의 제작비용이 저렴하고 제어하기 쉽기 때문에 SEM의 기본 검출기로 사용되고 있다.

<그림 23> SED(이차전자 검출기)의 구조
이차전자가 형광물질이 도포된 scintillator에 충돌하면 이차전자가 형광물질을 자극하여 빛을 방출하고, 이 빛은 lucite나 quartz로 구성된 light guide를 따라서 이동한 뒤PMT(photomultiplier)의 끝에 위치한 photocathode에 충돌하게 된다. Photocathode는 빛이 충돌하면 전자를 방출하는 물질로 coating이 되어 있으므로, 여기에서 나온 광전자들(photoelectrons)이 전자들의 개수를 비례적으로 증가시키는 photomultiplier에 들어간다. Photomultiplier에 의해서 발생된 약한 전압은 SEM의 preamplifier와 amplifier에서 증폭되는 과정을 거친다. 이 때 획득된 전기신호(아날로그 신호)는 디지털로 변환된 후 영상처리 과정을 거치게 된다.
가속된 전자빔은 시료 표면에서 1~5 ㎛ 깊이까지 침투하여 상호작용을 유발하며, 그 중 이차전자는 표면 부위에서 많이 방출되므로 표면의 형상을 잘 반영해준다. 이차전자는 결국 광전자라는 매개체를 거치게 되므로 방출량이 많을 경우 밝게, 그렇지 않을 경우 어둡게 나타나므로 모니터 화면에 명암의 이미지를 보여주게 된다.
이차전자 발생 효율에 미치는 인자로서 입사 전자빔이 시편의 면과 이루는 각도를 생각할 수 있는데, 만일 입사빔이 시편면과 90도의 각도로서 충돌하게 되면 전자빔이 깊숙이 침투하게 되므로 시편 내부에서 발생한 이차전자들이 시편 바깥으로 뛰쳐나오기 어렵다. 반대로 입사빔이 시편면과 거의 평행에 가까울 정도로 입사하게 되면 전자빔이 시편 내로 깊이 침투하지 못하게 되므로 많은 수의 이차전자들이 뛰쳐나와 검출기에 탐지되게 된다. <그림23>에서 보는 바와 같이 측면, 돌출된 얇은 부위, 모서리 부위에서는 이차전자들이 시편 밖으로 뛰쳐나올 확률이 높기 때문에 평탄한 면보다 밝게 나타나는데 이를 edge effect라 한다. 한편, SEM 이미지를 측정할 때 경우 좀 더 정확한 정보를 얻을 수도 있으므로 다양한 시도가 필요하다(그림 23).

<그림24> 시편 표면의 경사도에 따른 이차전자 생성량의 차이 [9] | <그림 25> Edge Effect 사례. 모서리 부위가평면보다 훨씬 밝게 나타난다. |
SED에서 가속전압을 높이면 전자빔이 침투하는 깊이가 증가하므로 contrast가 감소하지만 시편의 모든 형상(topology)으로부터 이차전자들이 방출될 확률을 증가시킬 수 있다. 만일 SEM관찰 중에 더 높은 contrast가 요구될 시에는 가속전압을 낮추어 contrast를 증가시킬 수 있다.불완전하게 coating된 시편이나 접지가 완전히 되지 않은 시편에서는 하전이 축적되어contrast가 증가할 수 도 있으나 전체적인 영상의 질은 나빠지게 된다. Coating이 불완전하면 입사빔으로부터 시편의 coating이 안된 부위에 정전하가 축적되어 밝게 보이게 되고 접지가 불안하면 축적된 전하들을 빨리 분산시키지 못하여 밝게 보인다.
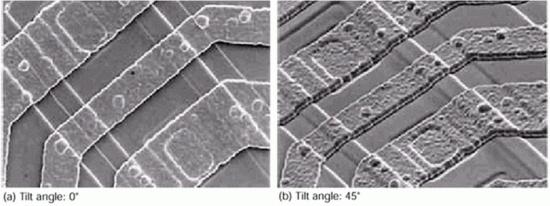
<그림 26> 시편을 기울여 측정한 이미지
n 후방산란전자 검출기(back scattered electron detector)
시료의 표면으로부터 반사(혹은 산란)되어 다시 시료의 표면 밖으로 방출되는 전자들을 후방산란 전자라 부르며 검출기는 흔히 대물렌즈 밑에 위치한다.
시료의 구성원자가 무거울수록 후방산란 정도는 더욱 커지기 때문에 평평한 시료의 표면에서 원자번호의 차이에 의한 대비가 후방산란 전자상에 나타난다. 따라서 후방산란 전자상으로는 이차전자검출기와 달리 시료의 조성에 대한 정보를 감지할 수 있다. 특히 원자번호의 차이가20 이상이면 인접상의 구별이 가능하다. 시료에 흡수된 전자의 에너지가 형광반응으로 가시광선 영역의 전자파를 발생하는 시료에는 Robinson형 검출기로 이 신호를 측정하여 영상화하는데 이는 형광 혹은 발광 물질의 상을 구분 관찰하는데 유용하다.

(a) (b)
<그림 27> 이차전자검출기(a)와 Robinson BSE 검출기(b)로 측정한 이미지의 비교.
n X선 분석: EDS / WDS

<그림 28> 전자현미경 이미지와 EDS의 X선 스펙트럼
1차 전자와 고체시료 사이의 작용으로 X선 및 장파장의 가시광선이 방출되는데, 이들을 검출하기 위하여 EDS(energy dispersive spectrometer)와 WDS(wave dispersive spectrometer) 검출기 및 cathodoluminescence 검출기가 시편실 공간에 위치할 수 있다. 이들은 1차 전자빔을 시편에 주사하여 발생하는 특성 X선의 세기를 검출하여 원소의 분포도를 측정하여 정성 또는 정량분석을 할 수 있는 SEM의 강력한 분석기능이다.
(4) 고전압 발생장치
SEM에서는 전자빔을 발생시키는 전자총의 가속전압, 바이어스 전압(W-필라멘트의 경우), Filament 전류를 공급 최대 30kV의 높은 전압을 공급한다. 이차전자 검출기에는 이차 전자를 가속하기 위하여 신틸레이터와 Faraday 망에, 광증폭관(Photomultiplier Tube)이 신호 증폭을 하기 위하여 전극에 고전압을 필요로 한다. 전자총의 음극에 인가되는 고전압의 리플이 높을수록 이미지의 분해능이 떨어지므로 안정된 가속전압과 방사전류는 SEM의 핵심 기술 중 하나이다. 정전기로 인한 노이즈, 고전압 방전에 의한 전자회로의 오동작 등은 고전압 사용에 따른 부차적인 현상으로 이런 현상들을 효율적으로 억제할 수 있는 기술 등이 수반되어야 한다.
(5) Stage와 시편 Holder

<그림 29> Stage와 시편 Holder
SEM 시료는 스터드 등의 금속제 받침에 놓이고, 이 받침은 홀더를 통하여 접지되어 있다. 시편으로 입사된 전자가 방전되지 않으면, 뒤에 입사되는 전자빔에 척력을 가하여 시료에 입사되는 전자의 수가 감소되며 이차 전자의 진로에 영향을 주어 영상의 질을 떨어뜨리게 된다. 따라서, 세라믹이나 고분자 등의 부도체시료는 탄소막의 진공증착이나 금-팔라듐을 증착하여 전도성 코팅을 하여야 한다. 시편 홀더는 5축으로서 X, Y, Z축 방향의 이동과 회전 및 기울임이 가능해야 하며 정밀한 제어가 필요하다. 넓은 시편을 이동하면서 관찰하거나, 파면 등을 유리한 방향과 위치에서 관찰할 수 있다. EDS 등의 분석기능을 갖춘 SEM과 반도체 웨이퍼와 같은 대면적의 시료 관찰을 위한 SEM 등의 홀더는 모터를 장착하여 사용하기도 한다.
(6) SEM Electronics
SEM의 전자회로는 디지털 영상기술과 결합되면서 비약적으로 발전하였다. 초기 SEM은 CRT모니터를 사용하였기 때문에 주사 속도가 느렸으나 반도체 기술의 발달로 인해 고성능의 소형화된 processor, analog-to-digital 변환기, 대용량 저장장치, 뛰어난 제어장치 등으로 인해 뛰어난 해상도의 영상을 빠르게 얻을 수 있을 뿐만 아니라 파일로 저장되므로 활용도를 높일 수 있게 되었다.
전자 회로계는 크게 진공 제어회로, 주사회로, 영상신호처리회로 등으로 구분되며, 시스템을 제어하고 PC와 통신을 통해 데이터를 수집, 가공, 저장한다. 진공제어 회로는 진공계 각 단의 밸브를 여닫는 역할을 하고 냉각수 이상, 유확산 펌프 히터 단선, 전원 이상, 진공상태의 이상 유무 등을 감지하여 시스템을 안전하게 동작시키며, 밸브의 동작은 진공계를 초기화할 때 경통의 진공도에 따라 순서대로 동작한다. 주사회로는 주사신호발생회로(scan generator)와 배율조정회로 렌즈전류조정회로 등으로 구별되며 이는 상호 연관되어 있다.
(7) 진공계
전자 현미경에서는 10‐5 torr 이상의 고진공이 사용하므로 대체로 유회전 펌프(rotary vacuum pump)와 유확산 펌프(oil diffusion pump)를 직렬연결 사용한다. 유확산 펌프는 저렴하고 진동이 거의 없으며 유지보수가 쉽기 때문에 널리 이용되고 있으나 오일을 높은 온도로 가열하기 때문에 냉각수를 필요하고, 오일 증기의 역유입(back streaming) 현상으로 경통 내부를 오염시킬 우려가 있기 때문에 개폐밸브의 자동 차단기능이 필수적으로 요구된다. 유확산 펌프는 최고 10‐8 torr 정도의 진공을 유지할 수 있으므로 유확산 펌프 진공계는 주사현미경에서 가장 많이 채택되고 있다.
유확산 펌프는 원통형 구조의 경통에 적당량의 오일을 충진하고 밑면에 히터를 장착한다. 히터에서 충분히 가열된 오일증기는 제트침니(jet chimney)를 통해 초고속으로 분사되는 oil stream에 의해 경통 안에 있는 기체를 빨아들이는 역할을 한다. 유확산 펌프는 먼저 유회선 펌프로 10 torr 이하로 내부진공을 뽑고 오일을 충분히 가열하여 침니 내부에서 압축된 오일증기는 노즐을 통하여 고속으로 벽면으로 이동하므로 그 주변압력이 떨어지고 결국 펌프와 경통 내부의 압력 차이로 경통 안에 있는 기체를 빨아들이므로 진공펌프 역할을 한다. 이 오일증기는 냉각수에 의해 오일로 응결되어 밑으로 떨어지고 다시 증기가 되는 순환운동을 하게 된다.
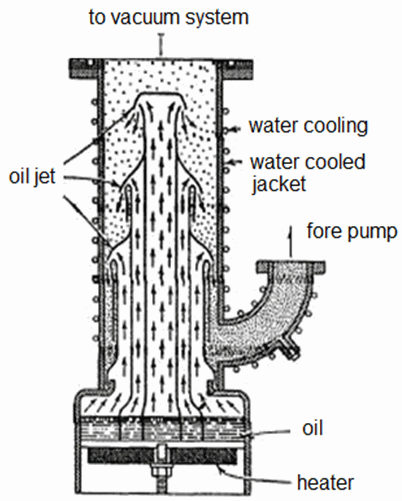
<그림 30> 유확산 펌프의 원리
진공계의 동작순서는 유회전 펌프로 유확산 펌프를 진공시키는 동안 유확산 펌프는 충분히 가열시킨 후(약 15‐20분 소요), 유회전 펌프로 경통을 진공시킨다. 이것은 예비진공 (rough vacuum)으로 유확산 펌프가 충분히 동작될 수 있도록 한다. 예비 진공이 완료되면 유회전 펌프는 유확산 펌프에 다시 연결되고 유확산 펌프가 경통에 연결되어 충분히 진공을 뽑게 된다.이 모든 과정 즉 밸브를 여닫는 일련의 과정은 경통 또는 폄프에 장착된 진공 게이지 (vacuum gauge)에 의해 자동적으로 이루어진다.
터보펌프(turbo molecular pump)는 오일증기가 오염될 우려는 없으나 가격이 비싸고 펌프자체가 고속으로 회전하므로 경통에 진동이 직접 전달되며, 일정 시간을 사용하면 축 베어링을 교체해야 한다. 터보펌프는 일정한 각도를 가지고 고속으로 회전하는 blade와 가스분자가 충돌하면서 chamber 내부의 기체분자들이 빨려나오는 원리를 활용한다. 터보펌프는 초기 진공을 잡는 시간이 불필요하며, 진공을 뽑는 과정에서 부식성 또는 반응성 물질의 잔류가 없지만 유확산 펌프에 비해 가격이 비싸고 질량이 가벼운 분자들의 경우 배기속도가 떨어진다는 단점이 있다.
한편, 텅스텐 필라멘트 대신에 LaB6 필라멘트를 쓰기 위해서는 훨씬 높은 진공을 유지해야 하므로 앞에 말한 진공시스템 외에 이온게터펌프(ion getter pump)가 추가로 요구된다.
4. 결론 - 전자현미경 시장의 전망
전자현미경은 나노기술의 발전 등 과학기술의 고도화 및 미세화로 인해 더욱 다양한 용도로 활용되고 있으며, 반도체/디스플레이, 나노 융합기술, 신소재, 기계부품, 생명과학 등 첨단산업 전 분야의 R&D, 품질관리, 교육을 위한 기반 인프라 기술이라 할 수 있다. 시장보고서들에 따르면 전자현미경 시장은 매년 시장규모가 12~13% 정도 성장하고 있으며, 2008년 1.8조원에서2015년 5조원 규모로 확장될 것으로 예상된다.
2008년도 전자현미경(SEM, TEM, EPMA 등) 세계시장 점유율은 Hitachi 32%, JEOL 29%, FEI 27%, 기타 12%라고 한다. [4,5,6] 일본은 국가적 차원에서 전자현미경 산업을 육성한 결과60년대 후반부터 시계시장을 주도하고 있으며, Hitachi와 JEOL, Keyence 등이 세계시장의 60%이상을 점유하고 있다. 아직까지 우리나라는 생산 규모 측면에서는 미미하기 그지 없지만 일본, 미국, 독일, 체코에 이어 세계 다섯번째 전자현미경 생산국이란 사실은 나름대로 의미가 크다고 볼 수 있다.
교육과학기술부는 지난 10월 21일 전자현미경을 세계적으로 성장성이 높은 25개 첨단분석장비 중의 하나로 선정하고, 2010년부터 집중 육성할 계획이라고 발표하였다. 아직까지 구체적인 계획안이 발표되지 않았고 산업현장에서 요구하는 실제적인 정책이 실행될 지 알 수 없으나 초정밀 측정기술의 국산화 없이는 국제경쟁력을 갖춘 우수한 제품을 개발할 수 없다는 점을 강조하고 싶다.
우리는 일본의 정밀 측정기기 산업의 육성을 위한 노력에 주목할 필요가 있다. 일본은 1930년대 후반에 국가 과학기술의 발전을 위해서는 전자현미경 기술의 확보가 필수적이라는 판단 하에 문부성 주관으로 대규모 유학생을 독일에 파견하는 한편 산학연 공동연구를 추진하였다.그 결과 1941년 Hitachi가 TEM(HU-1)을 개발하였고, 2차대전이 끝난 후 JEOL, Shimadzu, Akashi 등 산업을 육성하여 1960년대부터 세계시장을 석권하게 되었다.
무엇보다 전자현미경 시장규모가 2015년에 5조원대에 이를 것으로 예상되는 결코 포기할 수 없는 거대시장이며, 나노산업 뿐만 아니라 기초과학 및 산업현장에서도 필수적으로 사용되는 인프라 산업이다. 전자현미경은 다양한 원천기술이 요구되는 고난도의 기술임은 틀림없지만 이미 널리 알려진 기술로서 국내 기업들이 후발의 이점을 최대한 활용하여 생산기반을 구축하는 한편, 특화된 기능을 개발하여 틈새시장을 비집고 들어간다면 글로벌 시장에서 충분한 경쟁력을 확보할 수 있을 것으로 확신한다. 나아가 산학연 공동연구를 통해서 창의적 기술을 개발한다면 10년 후 우리도 전자현미경 Global Top 5 회사를 갖게 될 것이다.
<Reference>
1. 윤존도, “주사전자현미경 분석과 X선 미세분석”, 청문각, 2005
2. 조양구, “전자현미경의 개발과 응용”, 화학세계, 2008.9
3. 박창현, 염미정, 엄창섭, “돋보기에서 FE까지 현미경의 변천사-생명과학적 관점에서”, 한국전자현미경학회지 제33권 제2호, 2003
4. WinterGreen Research Inc., "Worldwide TEM and SEM market share, Strategies, and Forecast, 2009 to 2015", Jan. 2009
5. JETRO Market Report, “Nanoscale Equipment for Visualization and Measurement”, March 2006
6. BCC Research, “ Microscopy: The Gloal Market”, June 2007
7. ㈜코셈, “Introduction to Electron Microscope”, 2009. 2
8. 안재평/박종구, “전자현미경의 회절원리와 나노구조분석 응용”, 고분자과학과 기술 17권4호, 2006. 8
9. 한국기초과학지원연구원, “초미세 세계와 전자현미경”
10. 백태선, “주사전자현미경(SEM)”, 2003. 9
11. 윤존도, SEM 워크샵 교육자료 “주사전자현미경의 개요 및 전자광학”, 2008. 7
12. 김석환, SEM 워크샵 교육자료 “신호검출 및 영상원리”, 2008. 7
13. 경상대, “전자현미경 및 재료분석기기”,http://super.gsnu.ac.kr/lecture/microscopy/em.html
14. 생산기술연구원, “미세조직평가”, http://microjoining.kitech.re.kr
15. 경상대 누리사업단 웹사이트 “주사전자현미경과 세라믹 특성평가”
16. Wikipedia, http://en.wikipedia.org/wiki/Electron_microscope
17. Ray F. Egerton, “Physical Principles of Electron Microscopy”, Springer
'분석장비 및 이론 > AFM & SEM &TEM' 카테고리의 다른 글
| AFM원리 (0) | 2013.04.18 |
|---|